随着半导体制造业的发展,颗粒污染对成品率的影响越来越大,因此需要对生产过程中影响成品率的颗粒污染进行有效控制。本文首先分析了半导体制造中颗粒污染的来源,然后介绍了用C控制图进行颗粒污染控制的方法及其不足,进而提出了用多元回归分析进行颗粒污染控制的方法及实施。
前言
随着集成电路线宽愈来愈向细微化发展,对电路的生产工艺技术提出更高更难的要求,一方面要刻蚀出亚微米线条,另一方面要保证线路缺陷控制在一定范围内,以保证芯片的功能和成品率。在IC制造过程中,一方面,工艺参数的随机起伏和线条的变化,使得制造出来的电路虽然有完整的功能,但由于部分参数不合格而成为废品;另一方面,由于引入了颗粒污染,使得集成电路丧失应有的功能而成为废品。前者导致的成品率损失称为参数成品率,后者导致的成品率损失称为功能成品率。而功能成品率是影响制造成品率的主要因素,因此,有效的过程颗粒污染控制对成品率的提高至关重要。本文将在讨论制造中颗粒污染来源的基础上,介绍颗粒污染进行有效控制的方法。
1颗粒污染的来源及检测
1.1 颗粒污染的来源
在半导体器件的生产过程中,颗粒污染有三个主要来源:生产环境;错误的圆片传递;生产线加工机台。前两种因素,可以通过优化设计和强化圆片传递训练,把颗粒污染降低到最低。在流片过程中由工艺设备产生的颗粒污染就成为成品率损失的最主要原因。据统计,对于1mm设计线宽的4M DRAM生产中,其污染颗粒50%是由于工艺设备产生的,其余50%的颗粒是由于工艺设备所产生的。到了0.5mm线宽的16M DRAM生产中,有工艺设备产生的颗粒增加到60%;在0.35mm线宽的64M DRAM生产中,由工艺设备产生的颗粒便增加到75%;而在0.25mm线宽的256M DRAM生产中,由工艺设备产生的颗粒将高竟达90%,成为最主要的污染源[1]。
1.2 颗粒污染的检测
一般说来,由颗粒污染导致的功能成品率损失要占总成品率损失的80%,而且,颗粒污染的数目越多,圆片的成品率就会越低,因此,了解各种加工设备产生的颗粒污染数目非常重要。
IC的制造工艺虽然很复杂,但都可以看成是下面两个基本工序的不断重复而组成:即导电物质的形成(掺杂)和绝缘物质的生长(淀积)。事实上,这两道工序也由一系列更基本的工序组成,如氧化,掺杂,薄膜淀积,光刻和腐蚀等[2]。因此,IC的制造过程可以看成是几个MASK循环进行组合。颗粒污染的检测就是以MASK进行的,每个MASK循环上检测一次颗粒污染数据。
通过对试片进行每片通过测试(PWP)[1]得到某MASK循环产生的颗粒污染数目,该方法的完整测试程序如下:
● 用圆片扫描仪检查并标出测试前圆片上已有的颗粒;
● 之后将扫描后的这种试片循环经过加工设备,模拟正常的圆片被加工工艺环境;
● 再次对试片进行扫描,这样由该MASK循环所增加的颗粒数目便被识别并记录下来。
2 颗粒污染的控制方法
2.1 应用C控制图进行颗粒污染过程控制
当质量数据为计数值时,可以使用C控制图进行过程控制,因此我们可以考虑使用C控制图进行颗粒污染的过程控制。但C控制图在使用上必须假设被控制数据为泊松分布[3],其隐含下列特性:
● 颗粒污染的发生均匀的分布在任何位置;
● 颗粒污染的出现互相独立。
而在IC制造中,随着晶圆面积的增加,颗粒污染在晶圆上的分布位置会有群聚现象,此时若采用传统的C管制图将会产生I类误差(I类误差是指控制图发出警报,而实际上过程并没有发生变异的情况)过高而导致过多的错误警告信息,一般使用上会加宽控制限的距离来降低I类误差,但这种方法的缺点是,没办法有系统的指定I 类误差的大小,而且,加宽控制限会导致控制图的侦测能力降低。
2.2 应用回归分析控制过程颗粒污染
随着先进过程控制(APC)方法的提出,人们发现对于不符合传统控制图使用条件的质量数据,可以通过对过程建模来确定控制限[5],因此我们设想通过对半导体制造过程进行建模来控制过程中的颗粒污染数目。
根据颗粒污染的数据采集特点,设过程的输入变量为每个MASK层的颗粒污染数目,输出变量为针测成品率,用多元线性回归分析来对该过程产生一个线性方程。该分析的目标是:
● 确定在哪个MASK层中颗粒污染最大程度的降低成品率;
● 确定所检测的MASK层的颗粒污染数目的控制限;
● 预测该LOT进行针测前的几个星期内的成品率。
2.3 应用回归分析控制过程颗粒污染的例证分析
某产品由三个MASK层组成,MASK1层, MASK2层, MASK3层,每层的颗粒污染数据及针测成品率是来自某半导体厂的93个样本值。(由于数据量过多,本文在此就不做表列出了)
2.3.1 用多元线性回归分析的可行性
(1) 很多文献指出,对随机变量进行多元线性回归要小心,但是当数据量涵盖了较长一段时间范围时,是可以使用多元回归分析的[6]。
由于我们分析的成品率数据并不是生产线上所有的成品率数据集合,而是在该集合中剔除了那些低于某个成品率数值(一般情况下,当成品率数值低于某个值,我们认为过程中存在着系统变异),因此,该子集中成品率数据近似为正态分布,符合多元回归分析的应变量分布为正态的假设[4]。
对输入变量和输出变量做散点图(如图1~3)。
从散点图上可以看出,输入变量与输出变量间存在着一定的线性相关性。
2.3.2 进行回归计算
设回归方程为:
Y=b0+b1×m1+b2×m2+b3×m3 [4]
Y表示被测圆片的成品率;m1,m2,m3分别表示该圆片上检测到的MASK1,MASK2,MASK3层的颗粒污染数目。
用SPSS软件对上述数据进行计算,结果如下:
因此,回归方程可以表示为:
Y=86.337-0.152×m1-0.0091b2×m2-0.0086×m3
利用上面回归方程我们可以:
(1)找出颗粒污染数目对成品率影响最大的MASK层
MASK1层的颗粒污染数目对成品率影响最大,MASK2次之,MASK3层最小, 与散点图上显示的结果基本一致。因此对颗粒污染的过程控制重点应该放在MASK1层上。
(2)对各MASK层设定颗粒污染数目的控制限
由于电性测试并不能识别圆片上所有的不合格品,因此圆片上通过了测试的晶粒也可能存在隐藏的缺陷,在成品率较低的圆片上,这种可能性就变得很大,为了顾客的利益,成品率低的圆片都将被整片废弃,由此造成很大的浪费。因此,需要对过程中检测到的颗粒污染个数设定控制限,当圆片上的颗粒个数超出了该控制限,在该加工步骤就可以将其废弃或者重做,这样可以节省时间和成本。
利用上面回归方程对颗粒污染数目设定控制限:
对上述93个样本计算m2,m3的平均值,用该值代表MASK2,MASK3层颗粒污染数目的正常水平,代入上面公式,得
Y=84.027-0.152×m1
如果假定,当圆片的针测成品率<0.78时,就必须被拒收,则有:
Y=84.027-0.152×m1>78
m1<39
所以,MASK1层颗粒污染数目的控制限为39个。
可以使用同样的方法对MASK2,MASK3层进行计算。
3 结束语
由于影响半导体制造成品率的因素过于复杂,在使用常规的质量控制图进行过程控制时,往往不能达到提高成品率的目的,如果能够从最后的成品率分析进行过程控制,却能得到较好的效果,本文介绍的多元回归分析就是这样一种方法。
参考文献:
[1] 童志义,大圆片批生产中的在线检测工艺及设备,电子工业专用设备,1997;(4):9-16.
[2] 赵天绪,郝跃,集成电路局部缺陷模型及其相关的功能成品率分析,微电子学,2001.4.
[3] 周纪芗,茆诗松,质量管理统计方法,中国统计出版社,1999.
[4] 何晓群,刘文卿,应用回归分析,中国人民大学出版社,2001.6.
[5] Feray -Beaumont, S, Corea, R., Tham, M.T. and Morris, A.J.,Process Modelling for Intelligent Control, Engineering Applications of Artificial Intelligence, 1992, Vol.5, pp.483-492.
[6] G Box, W Hunter, and J Hunter, Hazards of Fitting Regression Equations to Happenstance Data, Statistics for Experiments ,New York: Wiley, 1978.
作者简介:
李敬(1980—),女(汉族),河北衡水人,硕士研究生,主要从事半导体制造的质量控制,成品率分析等。
钱省三(1944—),男,浙江诸暨人,研究员,博士生导师,上海理工大学工业工程研究所所长、微电子发展研究中心主任;1968年清华大学无线电系毕业,长期从事半导体产业发展战略与制造管理研究。
- 推荐
- 政策
- 市场
- 企业
- 产业
- 技术
- 专栏
- 招标
- 更多
-

-

-

-

-

-

-

-

-

- 光伏2.5GW,2020年第十批可再生能源发电补贴项目清单发布
-
 3星期前
3星期前 国网新能源云
国网新能源云 可再生能源发电项目补贴
可再生能源发电项目补贴
-

- 2021年,对光伏行业十个预期!
-
 4星期前
4星期前 智汇光伏
智汇光伏 电力投资企业投资光伏可再生能源2021光伏行业预测专题
电力投资企业投资光伏可再生能源2021光伏行业预测专题
- 行情
- 财经
- 展会
- 光热
- 储能
- 碳交易
- 能源互联网电改
-

- 第五届国际储能创新大赛参赛项目火热征集中
-
 3星期前
3星期前 中关村储能产业技术联盟
中关村储能产业技术联盟 国际储能创新大赛
国际储能创新大赛
-

- 第十届储能国际峰会暨展览会2021(ESIE2021)定档明年4月
-
 1个月前
1个月前 索比光伏网
索比光伏网 储能国际峰会
储能国际峰会
-

- 2021第四届京津冀光储充品牌展
-
 1个月前
1个月前 欧乐光伏网
欧乐光伏网 光储充品牌展
光储充品牌展
-

-

-

-

- 第十五届亚洲光伏创新与合作论坛在杭州召开
-
 3个月前
3个月前 索比光伏网
索比光伏网 亚洲光伏展
亚洲光伏展
-

-

- 第十五届AsiaSolar亚洲光伏创新展会在杭州召开
-
 3个月前
3个月前 索比光伏网
索比光伏网 AsiaSolar亚洲光伏创新展会
AsiaSolar亚洲光伏创新展会
-

-

- 以法为“舵”:助推可再生能源发展
-
 1年前
1年前 《中国人大》杂志2020年第1期
《中国人大》杂志2020年第1期 可再生能源
可再生能源
-

- 河南提前下达可再生能源发展专项资金,八企业获1842万元
-
 1年前
1年前 大河报网
大河报网 可再生能源发展
可再生能源发展
-

- 能源转型2020:不可预见的奇迹
-
 1年前
1年前 角马能源
角马能源 能源转型,能源物联网
能源转型,能源物联网
-

-

-

-

-

-

-

 推荐阅读
推荐阅读
 最新活动
最新活动- more
 新闻排行榜
新闻排行榜
- 日榜
- 周榜
- 月榜
-
1 中石化与PGT签框架协议,合作开发光伏、风电及综合能源

- 近日,太平洋绿色技术有限公司(Pacific GreenTechnologies,简称PGT)在官网宣布,其全资子公司太平洋绿色技术(上海)有限公司与中石化旗下中国石化新星石油有限责任公司签署了框架协议。中石化是全球最大的炼油、天然
-
2 光伏快报(2021年2月1日)

- 【光伏快报】2021年2月1索比光伏网精选光伏资讯!【头条】63家光伏企业2020年业绩抢先看:50%预计净利翻倍【要闻】环保政策落实不力,国家能源局被要求整改!【必读】1703个、6237MW!国家电网发布2021年第二批可再生能
-
3 晶科科技牵手临港集团 共谋智慧运维新蓝图

- 1月28日,晶科科技与上海临港经济发展(集团)有限公司(以下简称临港集团)成功签署了战略合作协议。该协议由晶科科技副总裁刘晓军和临港集团副总裁刘伟分别代表双方签署,晶科科技董事长李仙德、临港集团总裁吕鸣及双
-
4 光伏投资重回西部,2020年64%新增在三北!

- 根据国家能源局2021年一季度网上新闻发布会文字实录:2020年,全国光伏新增装机4820万千瓦,其中集中式光伏电站3268万千瓦、分布式光伏1552万千瓦。从新增装机布局看,中东部和南方地区占比约36%,三北地区占64%。下
-
5 一张图带你了解爱士惟的前世今生
-
1 210尺寸50GW,高景太阳能硅片项目开工

- 1月29日,广东高景太阳能科技有限公司50GW大尺寸单晶硅片项目开工奠基仪式顺利举行。根据此前披露的招标信息,该项目投资总额72亿元,其中一期项目投资27亿元。项目地址位于广东省珠海市金湾区三灶镇湖滨路北侧、机
-
2 11家企业、超400亿元跨界光伏制造,玻璃、硅片领衔搅动市场格局

- 在气候目标以及市值持续创纪录的双重加持下,光伏制造已经成为一个令人眼馋的行业,持续向好的发展空间与强大的盈利能力吸引了众多掘金者的跨界加入。从7家重磅加码光伏玻璃、某龙头企业前高管170亿元投建50GW单晶硅
-
3 浙江省委常委、宁波市委书记彭佳学调研锦浪科技

- 1月23日上午,浙江省委常委、宁波市委书记彭佳学一行莅临锦浪科技参观调研。锦浪科技董事长王一鸣陪同接待。彭书记走进锦浪科技股份有限公司的生产车间,详细了解生产工艺、市场销售和增资扩产情况,对企业快速发展
-
4 重磅!隆基发布2020年业绩预告:净利润达82到86亿

- 1月29日,隆基股份发布2020年度业绩预告。据公告,2020年公司实现归属于上市公司股东的净利润为82亿元到86亿元,与上年同期相比,同比增加55.30%到62.88%。公告称,2020年业绩预增的主要原因是2020年全球光伏新增装
-
5 山西新能源如何发展?山西省能源局局长这样说

- 在日前召开的以能源革命国际合作为主题的2019年太原能源低碳发展论坛上,来自国内外能源领域的专家、学者以及从业人员走进能源大省山西,聚焦这里的能源革命及转型发展。论坛期间,山西省能源局党组书记、局长王启瑞
-
1 又一只光伏ETF明日上市,重仓隆基、通威、阳光电源!

- 近日,索比光伏网获悉,银华光伏50ETF(交易代码:516880)将于1月18日上市,为投资者提供更多选择。近年来,各国政府不断重视碳排放给地球带来的压力,光伏作为一种清洁发电方式,是实现碳达峰、碳中和目标的重要途
-
2 官宣!辛保安任国家电网公司董事长

- 1月18日,国家电网在公司领导介绍中明确,辛保安担任董事长、党组书记。至此,空悬一个多月的国家电网一把手位置终于明确!辛保安简历:辛保安,男,汉族,1960年10月生,河南辉县人,中共党员,1982年7月参加工作,
-
3 2021年中国光伏产业链及市场投资前景深度分析

- 中商情报网讯:光伏产业是基于半导体技术和新能源需求而兴起的朝阳产业,是未来全球先进产业竞争的制高点今年以来,光伏板块利好频现,整体涨势不俗。不论是双循环的提出还是光伏平价上网时代将至,都将推动光伏产业
-
4 山西2021年政府工作报告:发展新能源储能、能源装备制造产业 开展能源互联网建设试点

- 近日,山西省长发表2021年政府工作报告提到:实施碳达峰、碳中和山西行动,把开展碳达峰作为深化能源革命综合改革试点的牵引举措,研究制定行动方案。推动煤矿绿色智能开采,推进煤炭分质分级梯级利用,抓好煤炭消费
-
5 2020年光伏组件行业研究报告
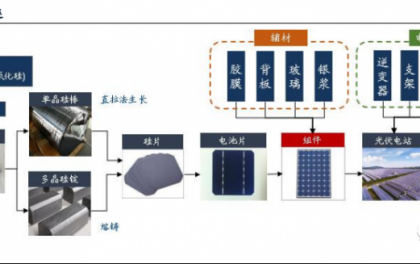
- 一、渠道品牌奠定先发优势,成本构筑核心壁垒(一)组件技术及资金门槛低,投资性价比高组件生产流程简单,技术壁垒低。组件即太阳能板,是光伏发电系统的核心组成部分,位于光伏产业链末端,上游为生产材料电池片,下